什么是球形触点陈列(BGA)
BGA封装出现于90年代初期,现已发展成为一项成熟的高密度封装技术。在半导体IC的所有封装类型中,1996-2001年这5年期间,BGA封装的增长速度最快。在1999年,BGA的产量约为10亿只,在2004年预计可达36亿只。但是,到目前为止该技术仅限于高密度、高性能器件的封装,而且该技术仍朝着细节距、高I/O端数方向发展。BGA封装技术主要适用于PC芯片组、微处理器/控制器、ASIC、门阵、存储器、DSP、PDA、PLD等器件的封装。
球形触点陈列(BGA),表面贴装型封装之一。在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI芯片,然后用模压树脂或灌封方法进行密封。也称为凸点陈列载体(PAC)。图1是BGA封装图。引脚可超过200,是多引脚LSI用的一种封装。封装本体也可做得比QFP(四侧引脚扁平封装)小。例如,引脚中心距为1.5mm的360引脚BGA仅为31mm见方;而引脚中心距为0.5mm的304引脚QFP为40mm见方。而且BGA不用担心QFP那样的引脚变形问题。
BGA封装的引出端为球或柱状合金,并矩阵状分布于封装体的底面,改变了引出端分布于封装体两侧或四周的形式。
图1 BGA封装图
相关热词:#球形触点陈列(BGA #电子电路图
 东芝牌RAC-45NHE型空调机电路图
东芝牌RAC-45NHE型空调机电路图
时间:2026-03-04
 杜鹃牌XPB2-3型洗衣机电路图
杜鹃牌XPB2-3型洗衣机电路图
时间:2026-03-04
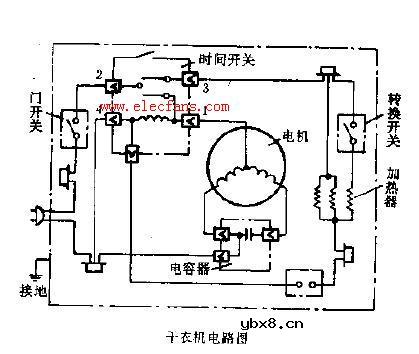 干衣机电路图
干衣机电路图
时间:2026-03-04
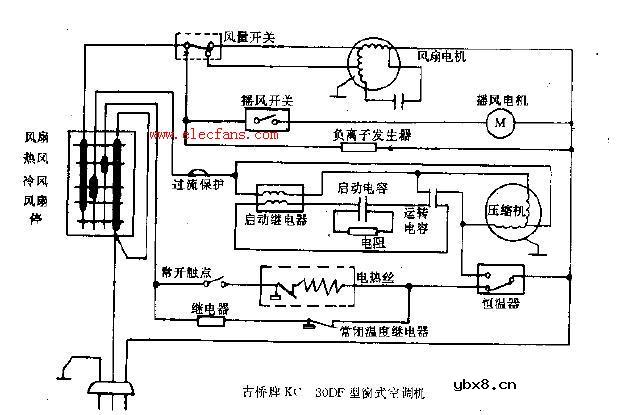 古桥牌KC-30DE型牌窗式空调机电路图
古桥牌KC-30DE型牌窗式空调机电路图
时间:2026-03-04
 好乐牌KC-42R型窗式空调机电路图
好乐牌KC-42R型窗式空调机电路图
时间:2026-03-04
 佳乐牌KCS-12型窗式空调机电路图
佳乐牌KCS-12型窗式空调机电路图
时间:2026-03-04
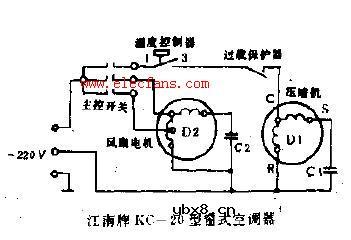 江南牌KC-20型窗式空调器电路图
江南牌KC-20型窗式空调器电路图
时间:2026-03-04
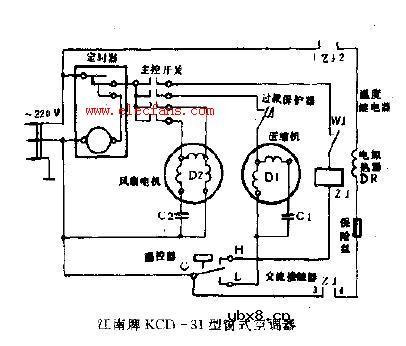 江南牌KCD-31型窗式空调器电路图
江南牌KCD-31型窗式空调器电路图
时间:2026-03-04
 金羚牌XQB30-5型全自动洗衣机电路图
金羚牌XQB30-5型全自动洗衣机电路图
时间:2026-03-04
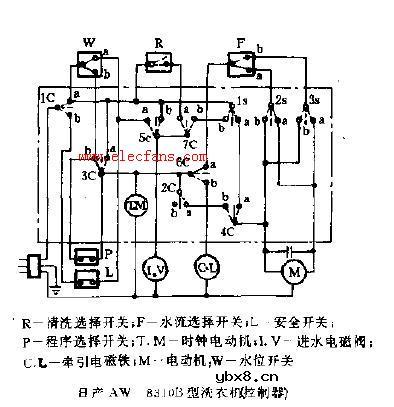 日产AW B310B型洗衣机控制器电路图
日产AW B310B型洗衣机控制器电路图
时间:2026-03-04
 瞬间抑制二极管(TVS)/瞬间抑制二极管(TVS)是...
瞬间抑制二极管(TVS)/瞬间抑制二极管(TVS)是...
时间:2026-03-04
 常用整流二极管型号大全
常用整流二极管型号大全
时间:2026-03-04
 S/HS固态继电器原理简介
S/HS固态继电器原理简介
时间:2026-03-04
 稳压二极管的选用和代换
稳压二极管的选用和代换
时间:2026-03-04
 TVS器件的电特性有哪些
TVS器件的电特性有哪些
时间:2026-03-04
 TVS二极管的分类/应用,TVS二极管的特点/选用...
TVS二极管的分类/应用,TVS二极管的特点/选用...
时间:2026-03-04
 快恢复二极管,快恢复二极管是什么意思
快恢复二极管,快恢复二极管是什么意思
时间:2026-03-04
 PN结温度传感器工作原理是什么?
PN结温度传感器工作原理是什么?
时间:2026-03-04
 双向二极管起什么作用?
双向二极管起什么作用?
时间:2026-03-04
 半导体材料的主要种类有哪些?
半导体材料的主要种类有哪些?
时间:2026-03-04